相关内容
-
HTCC陶瓷基板:高温工艺背后的高可靠性优势解析
在5G通信、新能源汽车、航空航天等高端制造领域,电子器件对稳定性的要求日益严苛,而HTCC陶瓷基板凭借高温工艺赋予的卓越性能,成为保障设备长效日益严苛,而HTCC陶瓷基板凭借高温工艺赋予的卓越性能,成为保障设备长效运行的核心材料。这种经1500-1600℃高温共烧而成的基板,用“烈火淬炼”的工艺换来了无可替代的可靠性优势。
-
陶瓷基板是昂贵易碎品?
提到 “陶瓷”,人们易联想到易碎品;提到 “电子元件”,常关联廉价材料。当二者结合成 “陶瓷基板”,不少人给它贴上 “昂贵脆弱”“冷门” 标签,但事实并非如此。今天我们就来逐一打破关于陶瓷基板的 3 个常见偏见,看看这个藏在电子设备里的 “硬核选手”,到底有多少被误解的实力。
-
从卫星到医疗:陶瓷基板的 “跨界渗透” 有多惊艳
在大众认知里,陶瓷基板似乎总与新能源汽车、5G 通信等热门领域绑定,是功率器件的 “散热管家”。但很少有人知道,这个看似 “专精” 的材料,早已悄悄跨界,在卫星通信、医疗设备等高精尖领域挑起大梁。从 3.6 万公里高空的低轨卫星,到手术室里的精准医疗设备,陶瓷基板凭借其独特的性能优势,打破了一个又一个技术瓶颈。今天,我们就来揭开陶瓷基板 “跨界高手” 的面纱,看看它如何在极端环境与精密场景中绽放惊艳实力。
-
大厂为何偏爱陶瓷基板?
在半导体、新能源汽车、5G通信等高端领域,陶瓷基板已成为头部大厂布局的关键组件。这一选择并非盲目跟风,而是器件向“高功率、高密度、小型化”升级的必然结果——传统树脂基板、金属基板的性能短板日益凸显,陶瓷基板则凭借散热、绝缘、耐候性等核心优势,精准破解了大厂的技术痛点,成为高端电子器件的“标配”。
电子封装用陶瓷基板材料及其制备工艺
陶瓷基板由于其良好的导热性、耐热性、绝缘性、低热膨胀系数和成本的不断降低,在电子封装特别是功率电子器件如IGBT(绝缘栅双极晶体管)、LD(激光二极管)、大功率LED(发光二极管)、CPV(聚焦型光伏)封装中的应用越来越广泛。
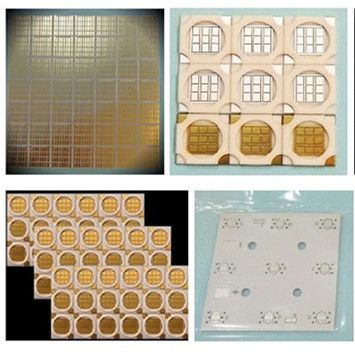
陶瓷基片主要包括氧化铍(BeO)、氧化铝(Al2O3)和氮化铝(AlN)、氮化硅(Si3N4)。与其他陶瓷材料相比,Si3N4陶瓷基片具有很高的电绝缘性能和化学稳定性,热稳定性好,机械强度大,可用于制造高集成度大规模集成电路板。

几种陶瓷基片材料性能比较
从结构与制造工艺而言,陶瓷基板又可分为HTCC、LTCC、TFC、DBC、DPC等。
高温共烧多层陶瓷基板(HTCC)
HTCC,又称高温共烧多层陶瓷基板。制备过程中先将陶瓷粉(Al2O3或AlN)加入有机黏结剂,混合均匀后成为膏状浆料,接着利用刮刀将浆料刮成片状,再通过干燥工艺使片状浆料形成生坯;然后依据各层的设计钻导通孔,采用丝网印刷金属浆料进行布线和填孔,最后将各生坯层叠加,置于高温炉(1600℃)中烧结而成。
此制备过程因为烧结温度较高,导致金属导体材料的选择受限(主要为熔点较高但导电性较差的钨、钼、锰等金属),制作成本高,热导率一般在20~200W/(m·℃)。
低温共烧陶瓷基板(LTCC)
LTCC,又称低温共烧陶瓷基板,其制备工艺与HTCC类似,只是在Al2O3粉中混入质量分数30%~50%的低熔点玻璃料,使烧结温度降低至850~900℃,因此可以采用导电率较好的金、银作为电极材料和布线材料。
因为LTCC采用丝网印刷技术制作金属线路,有可能因张网问题造成对位误差;而且多层陶瓷叠压烧结时还存在收缩比例差异问题,影响成品率。为了提高LTCC导热性能,可在贴片区增加导热孔或导电孔,但成本增加。
厚膜陶瓷基板(TFC)
相对于LTCC和HTCC,TFC为一种后烧陶瓷基板。采用丝网印刷技术将金属浆料涂覆在陶瓷基片表面,经过干燥、高温烧结(700~800℃)后制备。金属浆料一般由金属粉末、有机树脂和玻璃等组分。经高温烧结,树脂粘合剂被燃烧掉,剩下的几乎都是纯金属,由于玻璃质粘合作用在陶瓷基板表面。烧结后的金属层厚度为10~20μm,最小线宽为0.3mm。
由于技术成熟,工艺简单,成本较低,TFC在对图形精度要求不高的电子封装中得到一定应用。
直接键合铜陶瓷基板(DBC)
由陶瓷基片与铜箔在高温下(1065℃)共晶烧结而成,最后根据布线要求,以刻蚀方式形成线路。由于铜箔具有良好的导电、导热能力,而氧化铝能有效控制 Cu-Al2O3-Cu复合体的膨胀,使DBC基板具有近似氧化铝的热膨胀系数。

DBC基板制备工艺流程
DBC具有导热性好、绝缘性强、可靠性高等优点,已广泛应用于IGBT、LD和CPV 封装。DBC缺点在于,其利用了高温下Cu与Al2O3间的共晶反应,对设备和工艺控制要求较高,基板成本较高;由于Al2O3与Cu层间容易产生微气孔,降低了产品抗热冲击性;由于铜箔在高温下容易翘曲变形,因此DBC表面铜箔厚度一般大于100m;同时由于采用化学腐蚀工艺,DBC基板图形的最小线宽一般大于100m。
直接镀铜陶瓷基板(DPC)
其制作首先将陶瓷基片进行前处理清洗,利用真空溅射方式在基片表面沉积Ti/Cu层作为种子层,接着以光刻、显影、刻蚀工艺完成线路制作,最后再以电镀/化学镀方式增加线路厚度,待光刻胶去除后完成基板制作。
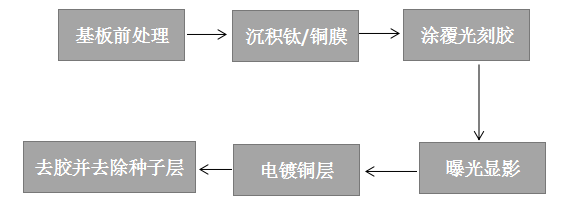
DPC基板制备工艺流程
DPC技术具有如下优点:低温工艺(300℃以下),完全避免了高温对材料或线路结构的不利影响,也降低了制造工艺成本;采用薄膜与光刻显影技术,使基板上的金属线路更加精细,因此DPC基板非常适合对准精度要求较高的电子器件封装。但DPC基板也存在一些不足:电镀沉积铜层厚度有,且电镀废液污染大;金属层与陶瓷间的结合强度较低,产品应用时可靠性较低。
参考资料:
郝洪顺.电子封装陶瓷基片材料研究现状
程浩.功率电子封装用陶瓷基板技术与应用进展
声 明:文章内容来源于先进陶瓷材料。














 沪公网安备31011802004982
沪公网安备31011802004982